
近日,电子科技大学、电子科技大学广东电子信息工程研究院(简称“电研院”)张波、周琦教授团队在氮化镓(GaN)高电子迁移率晶体管(HEMT)高压功率器件领域取得重大科研突破——首次系统揭示了650 V 高压Schottky-type p-GaN Gate HEMT在短路应力下由“热电子填充陷阱”机制主导向“热致空穴注入增强”机制主导器件可靠性退化的动态特征,建立了高压GaN HEMT功率器件清晰的电-热耦合退化物理模型,相关成果以《Nonmonotonic Instability of VTH and Rds,on in 650 V Schottky-Type p-GaN Gate HEMTs Under Short-Circuit》为题发表于微电子器件领域权威期刊《IEEE Transactions on Electron Devices》(VOL.73, NO.1, JANUARY 2026)。

氮化镓(GaN)高电子迁移率晶体管(HEMT)以其优异的开关速度与功率密度,已广泛应用于消费类电子,正加速向新能源汽车、数据中心等领域拓展。然而,在实际高频高功率应用场景尤其在工业应用中,GaN HEMT功率器件的短路可靠性与应用需求仍有差距,这也是当前业界极为关注的焦点之一。因此,深入研究器件的短路可靠性机理,厘清器件的退化特征及其物理机制对进一步提高器件的短路可靠性至关重要。
张波、周琦教授团队在650V肖特基型p-GaN gate HEMT(Schottky-type p-GaN Gate HEMT)的短路可靠性研究方面取得重要进展。首次观察到器件阈值电压(VTH)与导通电阻(Rds,on)在短路应力下表现出的非单调退化行为,揭示了短路应力下高电场诱发“热电子填充陷阱”与强自热效应导致“热致空穴注入增强”两种效应导致器件特性漂移的耦合作用与竞争机制。
以往研究普遍认为,随着短路应力增强,器件退化会持续加剧。研究团队在进行重复性短路测试时发现,在低应力条件下(Vgs≤4V&Vdc=100V),VTH正向漂移、Rds,on增大,符合传统认知;然而,当在高应力条件下(Vgs>4V&Vdc≥100V),随着短路应力电压增加,VTH漂移与Rds,on增加的程度反而减弱,甚至出现显著的VTH负向漂移现象。这一现象表明,器件退化的程度并非简单地随应力增强而单调加剧,而是“高电场”与“强热场”两种主导机制之间的动态竞争。
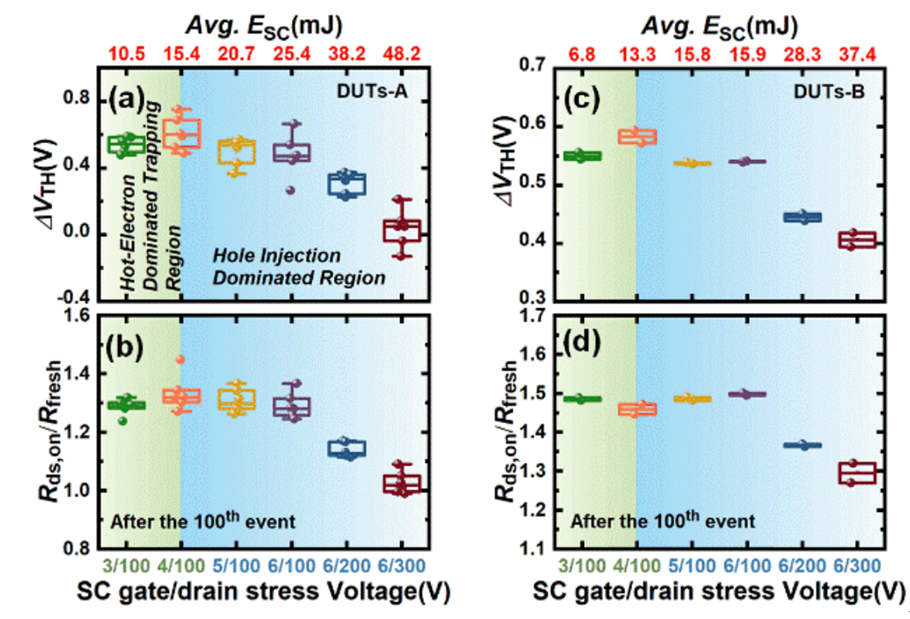
图1 DUTs-A在100次短路事件后(a)ΔVTH与(b)ΔRds,on相对于短路应力电压及能量的变化;DUTs-B在100次短路事件后(c)ΔVTH与(d)ΔRds,on相对于短路应力电压及能量的变化。
通过多组应力对比实验与TCAD仿真分析,研究团队揭示了器件阈值电压与导通电阻非单调退化行为背后的双重竞争机制:
低应力条件下——热电子填充陷阱主导
在较低栅压与漏压下,栅边缘漏极一侧的高电场加速电子使其成为“热电子”,部分“热电子”被p-GaN栅区域及器件漂移区分布的陷阱俘获,导致VTH正漂与Rds,on增加。
高应力条件下——热致空穴注入增强主导
当栅压与漏压进一步增大,短路能量大幅增加,引起器件结温显著升高(仿真证实可超过270°C)。高温不仅激活大量空穴从p-GaN栅注入到器件体内,部分空穴在器件体内填充陷阱,补偿了电子俘获效应,促使VTH由正向漂移向负向漂移转变;此外,器件在高短路应力下的强自热效应还抑制了漂移区热电子的产生,从而缓解了Rds,on的退化。
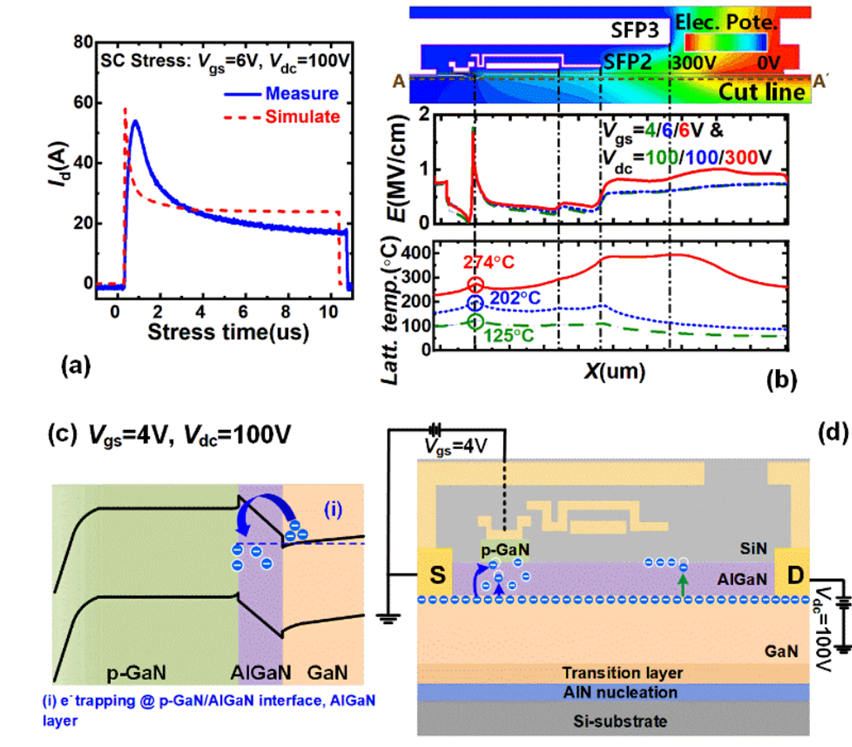
图2 (a)仿真与实测的短路电流Id波形对比;(b)在环境温度25°C、不同短路应力条件(Vgs=4V/Vdc=100V、Vgs=6V/Vdc=100V、Vgs=6V/Vdc=300V)下器件体内电场与晶格温度分布;(c)栅极堆栈的能带结构及(d)低电压短路应力下器件体内电荷分布与电子填充陷阱。
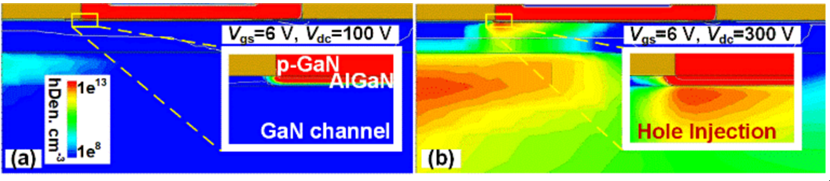
图3 在环境温度25°C、Vgs=6V、不同漏极应力电压(a)Vdc=100V;(b)Vdc=300V条件下空穴在器件体内的分布。
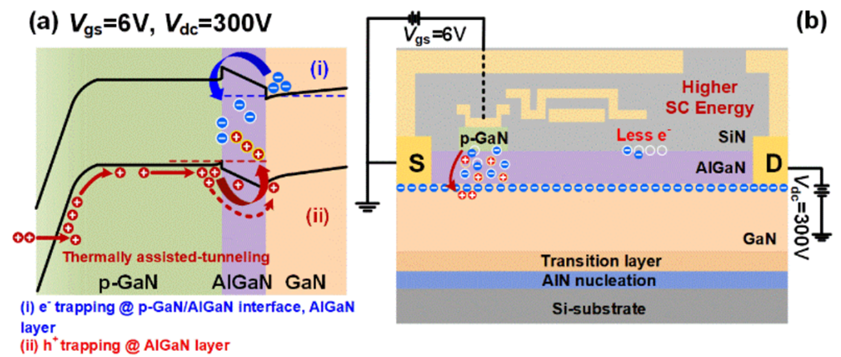
图4 高电压短路应力条件下,(a)栅极堆栈的能带结构与电荷迁移机制及(b)器件体内电荷分布与陷阱填充示意图。
为明确热效应在导致器件可靠性方面的关键作用,进一步通过不同环境温度下器件短路特性测试发现,在相同短路应力条件下,更高的环境温度同样诱发了VTH负向漂移与Rds,on退化减弱的现象,证实了“热致空穴注入增强”机制。此外,应力后器件参数的恢复动态特征也进一步证实了随着短路应力强度的变化主导器件可靠性退化的机制发生了动态变化。

图5 在Vgs=6V/Vdc=100V、不同环境温度Ta下,第100次短路事件后(a)阈值电压VTH与(b)导通电阻Rds,on的变化情况

图6 在Ta=25°C下,分别经受Vgs=4V/Vdc=100V和Vgs=6V/Vdc=300V重复短路应力后,相对于初始器件的特性恢复曲线:(a)阈值电压VTH;(b)导通电阻Rds,on
相关工作得到国家重点研发计划项目、国家自然科学基金、广东基础与应用基础研究基金的支持。
论文链接:https://ieeexplore.ieee.org/document/11266904
作者简介:
周琦,男,电子科技大学集成电路科学与工程学院(示范性微电子学院)教授、博士生导师,电子科技大学广东电子信息工程研究院特聘教授。2012年获得香港科技大学博士学位,同年加入电子科技大学工作。周琦教授长期致力于第三代宽禁带新型半导体材料、器件及其集成技术的研究,尤其在氮化镓(GaN)功率器件新结构、模型/器件物理、先进制备工艺与GaN功率集成技术领域具有深厚的研究积累。
周琦教授先后在IEEE-EDL、IEEE-TED、IEEE-TIE、IEEE-JESTPE、APL等本领域期刊发表SCI论文73篇,在IEDM、ISPSD 等重要国际会议发表论文45篇,其中在功率半导体国际顶级会议ISPSD发表论文24篇,包括GaN领域中国大陆首篇论文(2013)和首个大会口头报告(2015),各类学术会议邀请报告10余次。获授权中国发明专利20余项,转让多项。研究成果数次被国外著名半导体科技新闻媒体《Semiconductor Today》、《Compound Semiconductor》报道。先后担任国际学术会议“International Conference on Solid State Devices and Materials(SSDM)”TPC member、国内半导体著名期刊《Journal of Semiconductor》青年编委、SCI期刊《Microelectronic Engineering》副主编,SCI期刊《Electronics》 Guest Editor。
周琦教授作为负责人先后承担国家自然科学基金青年项目、面上项目、装备预研、四川省重点研发计划、广东省基础与应用基础研究项目、企业横向项目、国家重点实验室基金等课题15项;作为骨干曾参与国家科技重大专项、科技部重点研发计划、军科委XXX重点项目、国防重点实验室联合基金等课题7项。
周琦教授入选电子科技大学“百人计划”、2017 年“中国电子学会优秀科技工作者”、四川省“学术和技术带头人后备人选”,获得2015年四川省电子科学技术一等奖、2022年教育部自然科学奖二等奖。


